

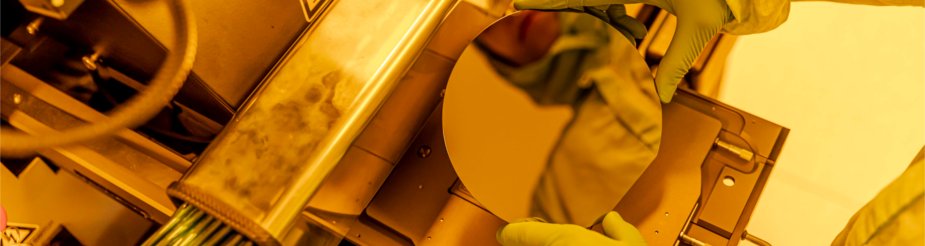
Trion Phantom 3 reactive ion etcher (RIE-ICP)
Location: Clean room CEMOP – lithography lab
Responsible: Pedro Barquinha
Description:
Reactive ion etching tool for up to 6” wafers, multiple gases available (CF4, SF6, Ar, O2), ICP option for high plasma density and endpoint detector for in-situ process monitoring.
Specifications:
- 200 mm bottom electrode
- Load-lock chamber for substrate loading/unloading
- Four gas lines (SF6, CF4, Ar and O2)
- 600 W, 13.56 MHz RF generator for RIE
- Inductively Coupled Plasma (ICP) source, 600 Watt, 13.56 MHz RF
- Intellevation laser endpoint detector and software for in-situ etching monitoring
- Heater/chiller with temperature control from 40 to 150 °C
- Touch-screen based GUI allowing for manual or automated etching processes
Responsible: Pedro Barquinha
Description:
Reactive ion etching tool for up to 6” wafers, multiple gases available (CF4, SF6, Ar, O2), ICP option for high plasma density and endpoint detector for in-situ process monitoring.
Specifications:
- 200 mm bottom electrode
- Load-lock chamber for substrate loading/unloading
- Four gas lines (SF6, CF4, Ar and O2)
- 600 W, 13.56 MHz RF generator for RIE
- Inductively Coupled Plasma (ICP) source, 600 Watt, 13.56 MHz RF
- Intellevation laser endpoint detector and software for in-situ etching monitoring
- Heater/chiller with temperature control from 40 to 150 °C
- Touch-screen based GUI allowing for manual or automated etching processes