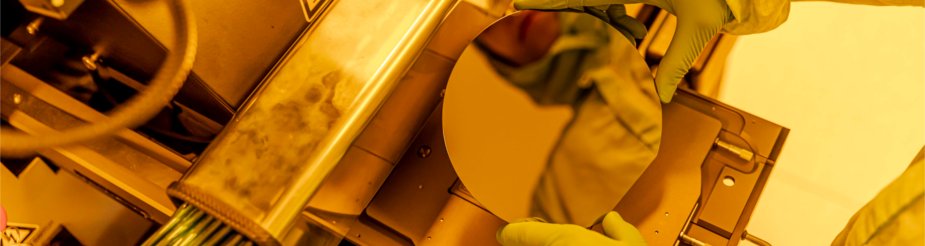


Scanning Electron Microscopy Focused Ion Beam (SEM-FIB) workstation
Responsible: Pedro Barquinha
The main features of the equipment are described below:
• SEM column;
• Schottky Field Emitter, resolution of 1.0 nm @ 15 kV, 1.9 nm @ 1 kV, acceleration voltage between 0.1 and 30 kV;
• FIB column;
• Ga liquid metal ion source (LMIS), resolution <7 nm @ 30 kV, acceleration voltage between 1 and 30 kV, probe current between 1 pA and 50 nA;
• Imaging with different detectors ;
• Everhart-Thornley type SE, In-lens SE and BSD detectors. Possibility of 3D reconstruction using combined SEM and FIB columns;
• Microstructural and chemical analysis;
• Oxford INCA Energy 350 (EDS), Oxford HKL Advance, Nordlys II-S (EBSD, EBSD 3D);
• Gas injection system;
• Deposition of C, Pt and SiO2, selective etching of dielectrics with XeF2, local charge compensation system to reduce charging effects in non-conductive samples;
• Lithography;
• Nanolithography using electrons or ions, milling of imported bitmaps or CAD files, electrostatic beam blanker;
• Heating stage;
• Kammrat & Weiss, heating up to 1050 °C for in-situ analysis of sample evolution with temperature;
• Nanoprobes;
• 4 Kleindiek nanotechnik nanomanipulators for electrical measurements of nanodevices.